來源:電工技術學報
作者:常桂欽、羅海輝、方 超、陳 杰、黃永章
摘要
功率半導體模塊通常采用減小結殼熱阻的方式來降低工作結溫,集成 Pin-Fin 基板代替平板基板是一種有效選擇。兩種封裝結構的熱阻抗特性不同,可能對其失效機理及應用壽命產生影響。該文針對平板基板和集成 Pin-Fin 基板兩種常見車規級 IGBT 模塊進行了相同熱力測試條件(結溫差 100K,最高結溫 150℃)下的功率循環試驗,結果表明,散熱更強的 Pin-Fin 模塊功率循環壽命低于平板模塊。失效分析顯示兩者失效模式均為鍵合線脫附,但 Pin-Fin 模塊的鍵合失效點集中在芯片中心區域,而平板模塊的鍵合失效點則較為分散。基于電-熱-力耦合分析方法,建立功率循環試驗的有限元仿真模型,結果表明,Pin-Fin 模塊的芯片溫變梯度更大,芯片中心區域鍵合點溫度更高,使芯片中心區域的鍵合點塑性變形更大,導致壽命較平板模塊更短,與試驗結果吻合。 0 引言 隨著社會發展和科技進步,電能對人類日常生活質量提升發揮著重要作用。絕緣柵雙極型晶體管(Insulated Gate Bipolar Transistor, IGBT)作為控制電能轉換的核心零部件,其性能和可靠性對于電動化的推廣應用起到推動作用。IGBT 正在朝著高可靠、小型化、高速開關、高功率密度、高工作結溫的方向發展,這對于芯片和封裝提出了更高的要求。IGBT 的封裝形式有分立器件和模塊,其中應用于新能源汽車、工業變頻器、智能電網、軌道交通領域的多為大功率 IGBT 模塊。服役中的 IGBT 模塊,在電能轉化的過程中產生損耗發熱,進而引起器件結溫的上升,對 IGBT 模塊的可靠性產生很大影響:一方面,過高的溫度會直接引起器件過熱失效;另一方面,隨應用工況不斷波動的芯片結溫,也會導致器件內部互連結構發生熱疲勞,引發器件的疲勞失效。基于上述原因,控制芯片結溫,降低器件工作時的溫度,成為器件開發的共性目標之一。在芯片層面,可以通過降低芯片壓降進而減小功率損耗,降低芯片結溫;在封裝層面,可以通過降低器件熱阻,提升器件散熱效率,也可以實現降低結溫的目標。 傳統 IGBT 模塊通常采用間接液冷的散熱方式,如圖 1a 所示,模塊采用平板基板,通過基板與散熱器表面貼合進行散熱。為了降低接觸熱阻,通常在基板底面涂覆導熱硅脂,以填充基板與散熱器表面之間的縫隙。為了降低模塊熱阻,一些車規級 IGBT模塊采用集成 Pin-Fin(針翅)基板的直接液冷的方案,如圖 1b 所示,避免了導熱硅脂層和散熱器表面的散熱路徑,使得散熱效率得到了極大地提升。模塊熱阻的降低,使得相同電流下,直接液冷模塊的結溫更低,結溫波動更小,根據 CIPS2008 壽命模型計算,直接液冷模塊的壽命更高。但集成Pin-Fin 基板的引入,也是為了模塊在相同結溫條件下增強其出流能力,在低的測試電流下顯然無法評估其封裝可靠性。文獻[7]在對比三家不同廠商的IGBT 模塊時,考慮模塊的壓降、熱阻特性的不同,分別對比了相同電流和相同熱力條件兩種測試模式下的可靠性壽命,結果表明兩種測試模式下的結論完全不同。 實際應用時,為了最大程度發揮模塊特性和降低成本,通常使模塊工作在最高允許結溫附近,即在相同熱力條件下更能體現出模塊封裝可靠性的差異。因此,即使結溫是影響封裝可靠性的首要因素,在模塊設計時也不能基于單一目標進行,文獻[8]認為功率模塊內部存在復雜的電-熱-力多物理場耦合效應,寄生參數、熱阻和可靠性相互制約,需要利用多目標協同優化設計方法。雖然集成 Pin-Fin模塊相比平板模塊熱阻降低,但散熱結構發生了變化導致熱容也存在差異,即使在相同的熱力條件下,內部各層組件也可能會表現出不同的溫度分布和溫度變化規律,最終都可能影響模塊的服役可靠性。文獻[9]研究了功率循環試驗中不同開通時間對模塊失效機理的影響,基于實驗和仿真分析揭示了內部溫度分布的變化會直接改變模塊的失效模式。進一步地,文獻[10]通過分立器件并聯的方式巧妙的驗證了芯片表面溫度梯度對功率循環壽命的影響,然而沒有在 IGBT 模塊中進行驗證。 本文旨在評估平板模塊和集成 Pin-Fin 模塊在可靠性方面的差異,通過相同熱力測試條件下的秒級功率循環試驗,并結合有限元數值模擬方法,從溫度分布、溫變速率、芯片結溫、模塊熱阻、熱容、鍵合線熱應力等維度進行對比,揭示了車規級可靠性標準條件下,散熱底板對模塊壽命的影響規律,對模塊的設計和應用提供重要指導作用。 1 功率循環試驗 1.1 試驗原理 IGBT 模塊的設計壽命長,新能源汽車中 IGBT模塊工作壽命要求達到15 年,風力發電機中IGBT 模塊工作壽命要求達到 25 年,機車牽引變流器中 IGBT 模塊工作壽命甚至要求至少達到 30 年。為了縮減試驗周期,通常對 IGBT 模塊進行加速壽命實驗,而功率循環試驗是公認的最主要的可靠性測試方法之一。功率循環是對 IGBT 模塊施加周期性電流,利用模塊自身工作時產生的功率損耗,使芯片結溫發生周期性波動,模擬芯片自生熱對模塊可靠性的影響,實驗原理如圖 2 所示。 功率循環試驗的控制策略有固定導通關斷時間、恒定結溫差、恒定殼溫差、恒定功率損耗等。固定導通關斷時間的控制策略下,由于器件的老化會使熱阻增加,引起芯片最高結溫和結溫差的上升,從而顯著縮短模塊的疲勞壽命,因此該方法的實驗條件最為嚴苛,也更加接近實際工況。恒定結溫差的控制策略下,隨著模塊的老化,通過動態調整集電極電流大小和散熱水流量,使功率循環試驗的各個階段,芯片的結溫差維持在相同的水平,相當于在器件老化過程中進行主動補償,因而會過高地估計模塊疲勞壽命,其他兩種控制策略也存在這種問題。因此,歐洲電力電子中心汽車電力電子模塊認證工作組頒布的 AQG 324 標準中,規定了只能使用第一種控制策略,在功率循環試驗過程中不能調整試驗條件對老化進行補償。 功率循環試驗通常選取電熱特征參數作為失效先兆參量,通過監測參數的變化來判斷模塊的狀態。常用的 IGBT 模塊失效特征參數主要包括芯片結溫 Tj、集射極飽和壓降 Vce(sat)和結-殼熱阻 Rth(j-c)。結溫通過溫敏電參數法測得,如小電流下飽和壓降Vce(sat),然后通過校準關系換算得到。飽和壓降Vce(sat)和結-殼熱阻 Rth(j-c)則可以反映鍵合線和焊料層的老化狀態,根據標準定義,當 Vce(sat)與初始值相比增加 5%或 Rth(j-c)與初始值相比增加 20%,可以判定器件失效,此時的循環數即為器件在該條件下的功率循環壽命。 1.2 待測器件及試驗條件 本文的待測器件是兩種不同散熱結構的 750V/400 A 車規級 IGBT 模塊,如圖 3 所示,該模塊為6 in 1 三相全橋電路拓撲,用于新能源汽車的電能轉換和能量回收。為了避免試驗條件對結果的影響,試驗采用單一控制變量原則,兩種模塊的功率循環試驗條件如表 1 所示,集電極電流 IC設置為 320 A,通過調節柵極電壓的大小,從而在相同的電流下使得 不 同 模 塊 達 到 相 同 的 熱 力 條 件 , 也 即 結 溫 差ΔTj≈100 K,最高結溫 Tjmax≈150℃。文獻[9]中表明柵極電壓對功率模塊壽命沒有影響,功率循環試驗中可以通過柵壓來調節模塊的功率損耗。為了盡可能多的獲得實驗數據,同時減小模塊各相之間的熱耦合帶來的影響,實驗過程中將 U 相、W 相的上管接入主電路,作為被測管。 2 功率循環試驗結果 2.1 熱特性對比 功率循環實驗過程中,通過測量模塊小電流下飽和壓降 Vce(sat),計算得到芯片結溫 Tj。實驗之前,需要對 Vce(sat)和 Tj 的關系進行標定,也即 K 曲線的標定。具體做法是,將模塊置于環境溫度試驗箱內,將環境溫度試驗箱的溫度設置為模塊工作結溫內的一個定值,經過一段時間的保溫,使模塊的溫度到達設定的溫度值,此時可以認為芯片結溫即為設置的環境試驗箱溫度。在模塊的柵極施加柵極電壓,使模塊處于開通狀態,為模塊施加一個微小的電流,如 100 mA,測量模塊的飽和壓降,即得到該溫度下模塊的飽和壓降值。隨后,改變環境溫度試驗箱的溫度,重復以上步驟,測量得到不同溫度下的模塊飽和壓降。對不同溫度下的模塊飽和壓降進行線性擬合,即可得到模塊 K 曲線。施加的小電流可以避免器件在電流作用下自生熱,導致芯片結溫升高,為測量帶來誤差。圖 4 給出了 4 只模塊的 K 曲線標定結果,擬合結果顯示,飽和壓降和芯片結溫的線性相關程度較高。 圖 5 給出了待測器件 1 和 3 在大電流關斷后冷卻過程中的芯片結溫變化。使用熱敏電參數 Vce(sat)來計算芯片結溫時,Vce(sat)-Tj 的關系是在小電流下進行標定的,因此只能用來測量小電流下的壓降,從而計算得到降溫階段的結溫變化。使用熱敏電參數 Vce(sat)來計算芯片結溫,雖然不能獲得功率循環試驗中加熱階段的結溫變化,但是降溫過程和升溫過程的溫度變化是對稱的。從測量結果來看,雖然兩種不同封裝形式的模塊的結溫波動范圍一致,但在降溫過程中,模塊 3 的結溫降溫速率高于模塊1,這是由于 Pin-Fin 基板模塊不僅結到水熱阻小于平板基板模塊,其熱容也更小,使得 Pin-Fin 基板模塊的散熱效率較高。由于 5 s 的冷卻時間相對較長,使得平板基板模塊的芯片結溫有足夠的時間冷卻到和 Pin-Fin 基板模塊相同的溫度,這也保證了散熱效率相對較低的平板基板模塊,仍然可以冷卻到最低結溫 50℃的實驗條件。 2.2 功率循環壽命 圖 6 是模塊 1 和模塊 3 的 U1 管,在功率循環試驗過程中的飽和壓降、結溫差、熱阻變化曲線。為了便于直觀地對各器件的功率循環壽命進行對比,選取模塊 1 的 U1 管失效時的壽命為 N0,其余各管的功率循環壽命以 N0 為基礎進行歸一化。老化過程中,熱阻的增幅不大,當器件失效時,模塊 1 的 U1管熱阻增大了 2.2%,模塊 3 的 U1 管熱阻增大了0.6%。實驗結束時,模塊 1 的 U1 管飽和壓降增大了 6.9%,模塊 3 的 U1 管飽和壓降增大了 5.1%。在圖 6 的飽和壓降曲線中,還可以看到兩次數據突變,這是由于鍵合線的脫落,使器件的電流回路電阻值增大,造成了飽和壓降的增加。由此可以判斷,器件的失效是由于鍵合線的脫落引起的,焊層出現了輕微的退化,但不是器件的主要失效模式。 4 只模塊的功率循環壽命統計結果如圖 7 所示。在相同的結溫差、最高結溫的條件下,平板基板模塊的壽命整體高于 Pin-Fin 基板模塊,就平均壽命而言,Pin-Fin 基板模塊約為 0.887N0,平板基板模塊約為 0.969N0,比 Pin-Fin 基板模塊高 9.2%。雖然Pin-Fin 模塊采用直接水冷的封裝形式降低了熱阻,提升了散熱能力和通流能力,但在相同熱力條件下,Pin-Fin 模塊的壽命低于平板基板模塊,僅從封裝可靠性的角度,Pin-Fin 基板模塊無法體現出優勢。 2.3 失效分析 當實驗終止時,對模塊進行失效分析。圖 8 是實驗結束后模塊 1 的 U1 管照片,可以看到,芯片金屬層上方的鍵合點出現了脫落現象,且脫落點不止一個,而襯板覆銅上的鍵合點完好。當鍵合線發生了脫落之后,同一芯片上剩余鍵合線的電流會瞬間增大,從而加速了鍵合線的脫落失效。 圖 9 是實驗后模塊 1 的 U1 管芯片焊層超聲掃描照片。從超聲掃描結果來看,焊層的退化程度較小,與功率循環試驗過程中熱阻的變化規律一致。 圖 10 給出了 4 只模塊的鍵合線失效位置分布。脫落的鍵合點均位于芯片表面金屬層區域,襯板覆銅上鍵合點完好。脫落的鍵合點分布于芯片中心,芯片邊緣鍵合線未發現失效。相對于平板基板模塊而言,Pin-Fin 基板模塊脫落的鍵合點更加集中于芯片中心位置。 3 有限元數值分析 為了進一步對比不同散熱基板形式模塊的熱機械性能,進行了電-熱-力多物理場耦合的有限元分析。有限元分析可以通過數值模擬的方式,獲得在實驗中不易測量的物理量,如溫度梯度、應力、塑性應變等,為分析問題、解決問題提供了新的方法和工具。 3.1 仿真模型 仿真采用全尺寸三維模型,為了減少計算量,去除了管殼、母排端子、輔助端子、硅膠,僅包含芯片、鍵合線、焊層、襯板、基板等結構,其中基板分為平板基板和 Pin-Fin 基板兩種形式。仿真模型忽略了模塊中可能存在的缺陷,焊層簡化為厚度均勻、無空洞的層狀結構。表 2 列出了仿真中使用的材料參數,其中,芯片電阻率采用文獻[21]中提出的基于器件 I-V 特性的等效電阻率計算方法進行定義,鋁鍵合線使用雙線性彈塑性模型,屈服強度為 30 MPa,切線模量為 500 MPa。焊料使用 Anand 粘塑性本構模型[23-24]其余材料設置為彈性材料。 采用電-熱-力多物理場耦合模擬功率循環試驗中電流產生焦耳熱,引起器件溫度上升,導致器件各部件間產生熱應力和變形。仿真條件和實驗條件相同,通過對芯片加載和實驗相同的電流來進行產熱,基板底部施加對流換熱邊界,模擬散熱器對模塊散熱。通過調整對流換熱系數,使芯片平均結溫在 50℃~150℃之間波動,與實驗條件保持一致。 3.2 仿真結果 圖 11 是平板基板模型和 Pin-Fin 基板模型的結溫變化曲線,可以看到,Pin-Fin 基板模塊的結溫變化速率高于平板基板模塊,在升溫階段,Pin-Fin 基板模塊芯片結溫早于平板基板模塊升高至最大值,在降溫階段,Pin-Fin 基板模塊芯片結溫下降也比平板基板模塊更早達到最小值。下降階段的溫度變化趨勢也在實驗中得到了證實,如圖 5 所示。 圖 12 給出了大電流關斷時刻,平板基板模塊和Pin-Fin 基板模塊芯片結溫的分布。大電流關斷時刻,芯片達到最高溫度,對于平板基板模塊,芯片中心最高結溫為 173.8℃,芯片邊角最高結溫為 106.2℃,溫度差值為 67.6℃。與之相對的 Pin-Fin 基板模塊,芯片中心最高結溫為 176.8℃,芯片邊角最高結溫為102.6℃,溫度差值為 74.2℃。結合圖 11,兩種不同結構的散熱底板封裝形式,在平均結溫相同的條件下,Pin-Fin 基板模塊的芯片結溫分布更加不均勻,芯片上的溫度梯度更大,芯片中心的最高溫度更高。 進一步地,提取平板基板模塊和 Pin-Fin 基板模塊芯片表面第 1 鍵合點和第 2 鍵合點位置的溫度數據,如圖 13 所示。鍵合點溫度分布趨勢與芯片結溫分布趨勢相同,芯片最中心區域的鍵合點溫度最高,工況相對芯片邊角的鍵合點更為嚴酷,增加了中心鍵合點失效的可能。Pin-Fin 基板模塊的鍵合點,最高溫為 170.82℃,平板基板模塊相同位置的鍵合點,溫度為 166.34℃,比 Pin-Fin 基板模塊低 4.48℃。Pin-Fin 基板模塊最邊緣鍵合點的溫度為 138.68℃,平板基板模塊相同位置的鍵合點,溫度為 142.13℃,比 Pin-Fin 基板模塊高 3.45℃。同一芯片上的同一排鍵合點,Pin-Fin 基板模塊的溫度差為 32.13℃,平板基板模塊為 24.21℃。由此可以看出,Pin-Fin 模塊鍵合點的溫度差異更大,溫度分布不均勻性相較于平板基板模塊更嚴重,這也解釋了 Pin-Fin 基板模塊的鍵合線的脫落更集中在芯片中央。平板基板模塊脫落的鍵合點相對分散,與工藝離散性相關。 圖 14 是大電流關斷時刻,平板基板模塊和Pin-Fin 基板模塊鍵合線的塑性應變分布,鍵合點處出現塑性應變的最大值,平板基板模塊鍵合線的最大塑性應變為 2.335×10-3,Pin-Fin 模塊鍵合線的最大塑性應變為 2.504×10-3,相較平板基板模塊高 7.2%。圖 15 給出了有限元數值模擬得到的芯片中心鍵合點在 3 個循環周期內的塑性應變累積,可以看到,第三個循環和第二個循環的塑性應變增量差別較小,單個功率循環周期內的塑性應變量趨于穩定。在第三個循環的過程中,平板基板模塊鍵合線的塑性應變變化量為 1.01×10-3,Pin-Fin 基板模塊鍵合線的塑性應變變化量為 1.36×10-3,比平板基板模塊高出34.7%。 在相同的平均結溫變化下,經過長時間的累積效應,Pin-Fin 基板模塊鍵合線的損傷將高于平板基板模塊鍵合線的損傷,從而導致相同平均結溫下Pin-Fin 基板模塊的功率循環壽命低于平板基板模塊。不論功率循環試驗還是仿真分析,對比的是相同結溫下的 Pin-Fin 模塊和平板模塊結溫變化速率對可靠性的影響,即在相同熱力條件下更能體現出模塊封裝可靠性的差異。實際 IGBT 服役工況下,Pin-Fin 模塊熱阻低,相同結溫下其出流能力相比平板模塊更強。為了最大程度發揮模塊特性和降低成本,追求更高的性價比,通常使模塊工作在最高允許結溫附近。IGBT 模塊產品的可靠性要求是通過指定溫度變化范圍條件下的功率循環試驗,Pin-Fin 模塊和平板模塊僅在功率循環壽命上存在差異。 4 結語 Pin-Fin 基板直接液冷的特性有效降低了 IGBT模塊整體熱阻,使得模塊散熱效率得到了極大地提升,在電動汽車應用領域正逐步替代傳統平板模塊。本文基于這兩種 IGBT 模塊,研究了不同散熱底板對模塊功率循環壽命的影響,可以得到如下結論: 1)基于封裝可靠性的視角,在相同結溫波動和最高結溫下,Pin-Fin 基板模塊芯片表面溫度分布不均勻程度更高,芯片表面溫度梯度更大,芯片最高溫度更高,中心鍵合線的塑性變形更大,導致芯片中心鍵合線更容易脫落,最終導致其功率循環壽命相比平板模塊更短; 2)基于應用可靠性的視角,由于 Pin-Fin 基板模塊熱阻更小,在相同輸出電流下其最高結溫和結溫波動更低,其服役壽命預計會更高。另外,更低的熱阻意味著在最高允許結溫下可以提高模塊的出流能力,同時其最高結溫和結溫波動也會增加,服役壽命也會低于平板模塊; 3)為了滿足應用的多重需求,模塊設計需要綜合考慮通流能力和可靠性能力,對于 Pin-Fin 基板模塊,在更換散熱底板降低模塊熱阻的同時,若要實現同等功率循環壽命,也需要采取措施提升其可靠性。兩者不是簡單的替換關系,在設計目標方面應該是獨立關系,在多物理場方面則是相互耦合關系,未來基于電-熱-力多目標優化的設計方法尤為重要。 綜上所述,本文從相同溫度條件下對比分析了兩種散熱底板下的功率循環試驗壽命差異。功率循環加速老化試驗與實際應用條件之間存在差別,需采用更恰當的加速壽命試驗方法和條件來表征器件在應用工況下的壽命。
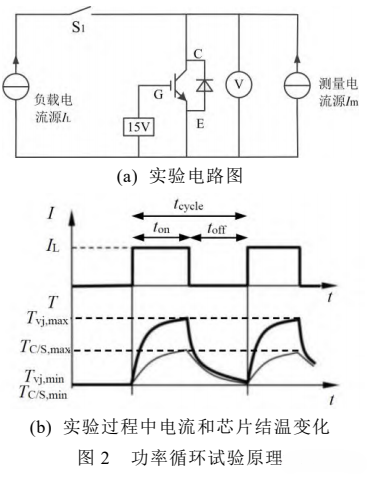
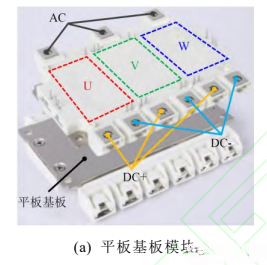
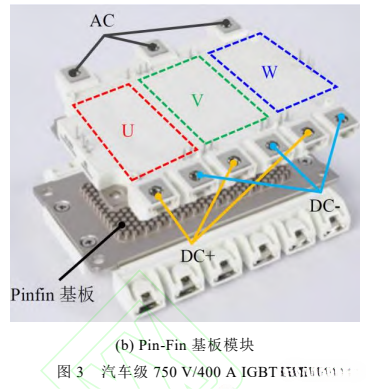





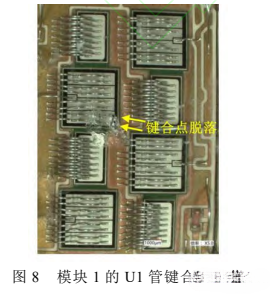





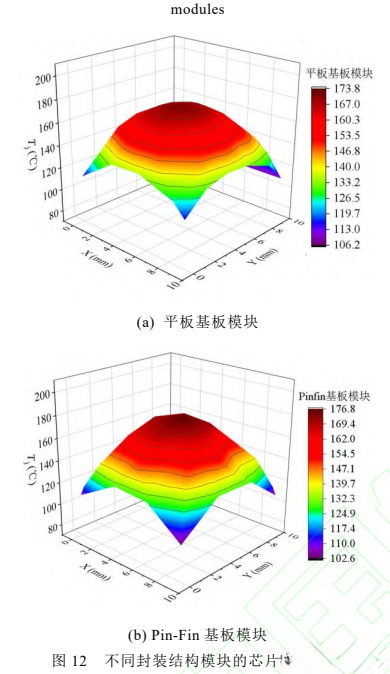

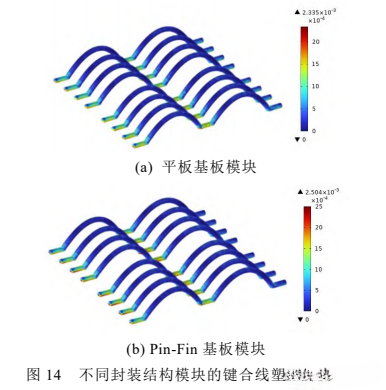

標簽: 導熱散熱 點擊: 評論:
