電子產品中,信號的連接有6個等級,分別為:
0級連接:晶圓內部門電路之間的連接;
1級連接:晶圓與封裝外圍電路之間的連接;
2級連接:元器件與單板之間的連接或元器件與元器件之間的連接;
3級連接:PCB之間的連接,如裝有多塊單板的背板或主板;
4級連接:子系統之間的連接,如插箱;
5級連接:獨立系統之間的連接,如網線連接。
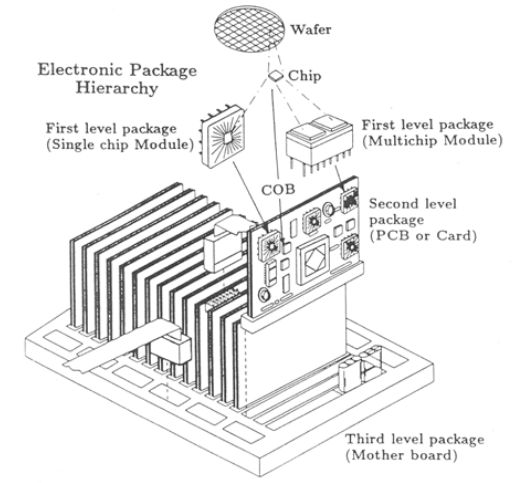
圖5-12 各級連接示意圖
芯片封裝熱特性一般只涉及1級連接和2級連接(圖5-13),但對于一些超高功率密度、需要在芯片內部實施微納尺度冷卻通道的芯片還需要考慮0級連接。
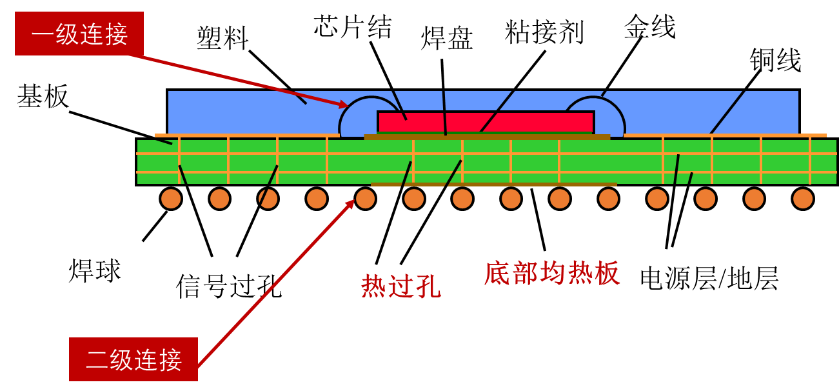
圖5-13 典型PBGA封裝元器件的一級連接和二級連接
在分別分析各類常見封裝形式的熱特性之前,我們先對典型芯片的內部組成物質(可以參考圖5-13)進行定性的熱分析:
1) 芯片結(或晶圓,die):硅或砷化鎵材料,芯片內部主要發熱源,導熱系數 ~102W/m.K;
2) 粘結劑 (Die Attach):將die固定到焊盤上的中間介質,導熱系數較低,可以添加高導熱填料(銀)增加導熱系數,導電銀漿就是一種常用的粘接劑。粘接劑的導熱系數~100 W/m.K;
3) 芯片焊盤(Die Pad):一般是銅材,有熱擴展和機械固定的作用,導熱系數 ~102W/m.K;
4) 鍵合線(Bond Wire):金或鋁制,數目等同于外面管腳數,信號傳輸、熱量傳輸,有些封裝形式中芯片沒有鍵合線(如FC-BGA封裝)。導熱系數 ~102W/m.K;
5) 基板(Substrate):類似于小尺寸的單板,有些芯片沒有基板。與單板類似,基板的導熱系數是各項異性的,水平方向~101W/m.K,厚度方向~10-1W/m.K(單板的相關熱特性會在本章第六節詳細闡述);
6) 引腳(Lead frame):銅金或鋁制,和內部的鍵合線一一對應,信號傳輸,熱量傳輸,有些芯片沒有引腳(圖5-13中的PBGA封裝就沒有引腳,元器件與單板之間的連接通過焊球實現)。導熱系數 ~102W/m.K;
7) 焊球(Solder ball):通常材料為錫鉛合金95Pb/5Sn或37Pb/63Sn,有些芯片沒有焊球(如圖5-9所示的兩種封裝形式,元器件與單板之間的連接通過引腳實現)。導熱系數~101 W/m.K;
8) 密封材料(Encapsulant):有金屬、陶瓷、塑料三種,塑料最為常用,外圍的、保護晶圓的材質,有些芯片(如裸die封裝的芯片)沒有密封材料。密封材料的導熱系數和材料類型緊密相關,塑料封裝導熱系數~10-1W/m.K,金屬或陶瓷封裝則可高達數十甚至上百W/m.K。
注:上述各個組成部分的材料參數參考的是典型元器件中可能出現的物質。部分特殊的封裝,材料類型及性質可能會有變化。
建立了芯片各組成部分的導熱系數量級概念之后,再來審視不同封裝形式元器件的熱特性就變得簡單了。當前常見的元器件封裝形式及其熱特性列示如下:
5.1 BGA—Ball Grid Array Package 球柵陣列式封裝
BGA封裝是當前高集成度芯片最常用的封裝,幾乎所有高端IC均在使用這一封裝。BGA封裝的最顯著特征是其二級連接是以圓形或柱狀焊點按陣列形式分布在封裝晶圓下面,并且以二維分布的形式陣列開來。
根據晶圓外圍封裝材料和基板材質的不同,BGA封裝又分為如下三種:
塑料球形封裝(Plastic Ball Grid Array Package,圖5-13):晶圓外圍包覆材料為塑料,基板為常見FR4基板,由于塑料導熱系數低,熱阻相對較高;
陶瓷球形封裝(Ceramic Ball Grid Array Package):使用陶瓷基板,結板熱阻相對較低;
裸die封裝(圖5-14):晶圓外圍不再包覆材料,而是直接裸露在外,結殼熱阻極低。

圖5-14 典型裸die封裝各組成部分
BGA封裝與單板之間的連接點是二維的形式,連接面更廣,從熱的角度上講,相當于傳熱面積更大,因此結板熱阻相對也低。另外,結到單板上的熱阻可以通過在基板上施加熱過孔,在基板底側正對芯片結之處亦可施加銅片來進行降低。裸die封裝的BGA芯片,芯片結直接暴露在外,最大程度降低了結殼熱阻。
5.2 TO——Transistor Outline Package晶體管外形封裝
TO封裝是較早期的封裝形式,多用在電源開關芯片。從熱特性角度上分析,TO封裝的元器件有如下特征:
1) 插針接觸單板,插針與芯片結通過鍵合線連接,熱量傳遞有限,通過單板的散熱阻力較大;
2) 芯片結外層往往包裹塑膠材料,故塑膠側熱阻較高;
3) 金屬側熱阻較低,是主要的傳熱路徑;
4) TO封裝的結板熱阻非常難定義,或者說,其值受工況影響較大。

圖5-15 TO封裝元器件示意圖
5.3 QFP---- Quad Flat Pack 四邊扁平封裝
四邊扁平封裝的元器件,其二級連接是一維分布,即只分布在芯片四邊。四周管腳通過鍵合線與內部晶圓進行一一對應連接,管腳另一側連接到單板上。
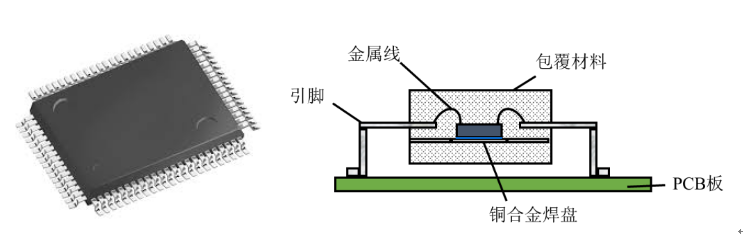
圖5-16 QFP封裝外形示意及典型內部結構和材料分布簡圖
從熱特性角度分析,QFP封裝的元器件有如下特征:
1) 熱阻高,引腳成為傳熱的重要途徑(一般仍<15%) ;
2) 多數QFP芯片底部不與單板接觸,底部加熱過孔收效甚微。特殊情況下可以在底部施加界面材料,連通芯片底殼和單板,降低結板熱阻;
3) 頂部由于大多采用塑料封裝,結殼熱阻也比較大;
4) 內部銅合金焊盤有助于在包覆材料內部均熱;
5) 塑料包覆材料導熱系數,當晶圓相對封裝尺寸較小時,芯片正頂部溫度較高,金屬散熱片均熱效果好,可能導致熱量回流,致使管腳溫度變高。當管腳溫度是芯片熱可靠性控制參數時,應當注意熱量的引流方向(如應加高而不是加長、加寬散熱器)。
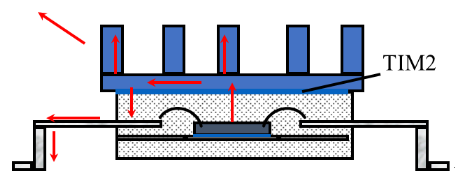
圖5-17 QFP封裝芯片的熱量回流現象(紅色箭頭表示熱量流動路徑)
5.4 QFN/DFN ---- (Quad/DualFlat No-Lead)四邊/雙邊無引腳扁平封裝
QFN和DFN是由QFP封裝演變而來。其最大區別是將四邊管腳收至芯片內部,使得芯片封裝體積大大縮減。

圖5-18 QFN/DFN和QFP/DFP封裝芯片尺寸對比(管腳數相同)
QFN的基本熱特性如下:
1) QFN中die所占封裝的比例往往很大,故Rjc和Rjb都較小;
2) 主要傳熱路徑:Die à焊盤à裸焊盤 à PCB;
3) 次要傳熱路徑:Lead;
4) QFN芯片底部一般直觸PCB地層,因此芯片板下添加熱過孔可以有效加強散熱。
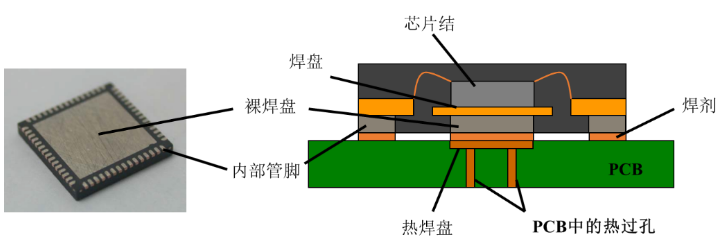
圖5-19 QFN芯片內部結構及其單板之間的連接示意圖
5.5 封裝演變趨勢和熱設計面臨的機遇與挑戰
體積是目前所有電子設備面臨的共同需求。所有的產品經理都希望在盡可能小的設備上實現盡可能強大的功能,這一需求促使著所有相關的行業飛速進步。元器件的封裝也是如此。在盡可能小的空間內擠入更多晶體管,并使用封裝技術保證芯片的可靠性正變得越來越難。下圖描述了1980年~2010年件芯片封裝形式的演進,可以清楚看到單板和芯片之間的連接正從管腳連接演變為晶圓底部焊球連接,并且人們正不斷嘗試提高晶圓所占比例,90年代就出現了芯片級封裝(Chip Scale Package,封裝相對于Die尺寸不大于20%)。從芯片設計層面,人們開發出了SOC(System on a Chip),而從封裝技術角度出發,人們一直在努力實現SIP(System in a Package)。對空間的持續追求和半導體制程的發展速度限制還促使人們開發出了3D封裝,及芯片堆疊甚至晶圓級堆疊。

圖5-20 芯片封裝趨勢圖
芯片封裝集成度的提升為產品散熱設計帶來了前所未有的挑戰。雖然架構的優化設計可以提高芯片的能效比,但晶體管的增多帶來的發熱量提升仍然導致元器件平均功耗逐年攀升。另外,由于封裝精度要求不斷提升,芯片對溫度變化帶來的力、電效應也越來越敏感。隨著半導體制程瀕臨物理極限,熱科學可能成為半導體行業進步的核心技術。
參考文獻:
[1] Sergio Lopez-Buedo, Eduardo Boemo. Electronic Packaging Technologies.
[2] Trends in Package Development. http://www.fujitsu.com/downloads/MICRO/fma/pdf/a810000114e.pdf
文章摘自 陳繼良(Leon Chen).《從零開始學散熱》.第3版. 第五章
