熱管理技術(shù)系列:電源散熱管理

電氣工程師提到“電源管理”這個詞時,大多數(shù)人會想到MOS管、轉(zhuǎn)換器、變壓器等。
其實,電源管理遠不止這些。
電源工作時會發(fā)熱,持續(xù)的溫升會引起性能的變化,最終可能導(dǎo)致系統(tǒng)故障;另外,熱量也會縮短組件壽命,影響長期可靠性。
因此,電源管理也涉及熱管理。關(guān)于熱管理,有兩個觀點有必要了解一下:
“微觀”|問題
單個組件由于發(fā)熱過多而過熱,但系統(tǒng)的其余部分及外殼溫度在限制范圍內(nèi)。
“宏觀”|問題
多個熱源的熱量累積導(dǎo)致整個系統(tǒng)溫度過高。
工程師需要確定熱管理問題有多少屬于微觀,多少屬于宏觀,以及兩者間的關(guān)聯(lián)程度。

簡單理解就是,一個發(fā)熱組件,即便溫升超過了其允許的極限導(dǎo)致整個系統(tǒng)升溫,不一定意味著整個系統(tǒng)過熱,但該組件產(chǎn)生的多余熱量必須散出去。
那么熱量要散去哪?
散到較冷的地方,可以是系統(tǒng)和機箱的相鄰部分,也可以是機箱外部(僅當(dāng)外部比內(nèi)部溫度低時才有可能)。
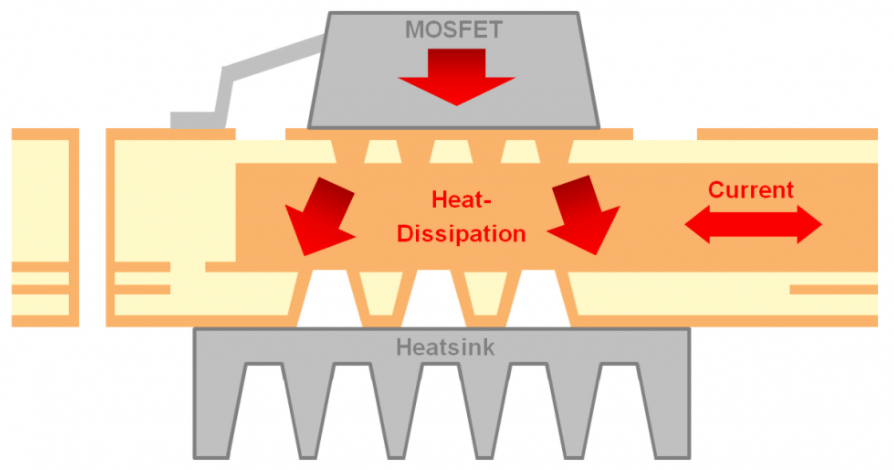
熱管理解決方案
熱管理遵循物理學(xué)基本原理,熱傳導(dǎo)有三種方式:輻射、傳導(dǎo)和對流。
對于大多數(shù)電子系統(tǒng)來說,實現(xiàn)所需的冷卻是先以傳導(dǎo)的方式讓熱量離開發(fā)熱源,然后再以對流的方式將其傳遞到其他地方。
進行熱設(shè)計時需要將各種熱管理硬件結(jié)合起來,以有效地實現(xiàn)所需的傳導(dǎo)和對流。
最常用的散熱元件有三個:散熱器、熱管和風(fēng)扇。
散熱器和熱管是無需電源的無源冷卻系統(tǒng),而風(fēng)扇是一種有源的強制風(fēng)冷系統(tǒng)。
散熱器
散熱器是鋁或銅結(jié)構(gòu),可通過傳導(dǎo)作用從熱源獲取熱量,并將熱量傳到氣流(在某些情況下,傳到水或其他液體)中以實現(xiàn)對流。

各種類型的散熱器
散熱器有數(shù)千種尺寸規(guī)格和形狀,從連接單個晶體管的小型沖壓金屬翅片到具有許多可以攔截對流空氣流并將熱量傳輸?shù)皆摎饬鞯某崞ㄖ感危┑拇笮蛿D壓件。
散熱器具有沒有移動部件、運行成本、故障模式等優(yōu)勢。
一旦散熱器連接到熱源,隨著暖空氣上升,對流就會自然而然地發(fā)生,從而開始并持續(xù)形成氣流。
盡管散熱器易于使用,但也存在一些弊端:
1、傳輸大熱量的散熱器體積大、成本高、重量大,且必須正確放置,會影響或限制電路板的物理布局;
2、翅片可能被氣流中的灰塵堵塞,降低效率;
3、必須正確連接到熱源上,才能使熱量暢通地從熱源流向散熱器。
熱管
它是熱管理套件的另一個重要器件,不需要任何形式的主動強制機制就可以將熱量從 A 點傳送到 B 點。

其包含燒結(jié)芯和工作流體的密封金屬管,本身不作為散熱器,作用是從熱源吸收熱量并將其傳送到較冷的區(qū)域。
當(dāng)熱源附近沒有足夠的空間放置散熱器或氣流不足時便可以使用熱管。
熱管工作效率高,可以將熱量從源頭傳送到更便于管理的地方。

工作原理:
熱源在密封管內(nèi)將工作流體轉(zhuǎn)變成蒸汽,而蒸汽帶著熱量傳遞到熱管的較冷端。在這一端,蒸氣冷凝成液體并釋放出熱量,而流體再返回到較熱端。
這種氣-液形態(tài)轉(zhuǎn)變過程是連續(xù)運行的,且僅由冷端和熱端的溫度差驅(qū)動。
在冷端連接散熱器或其他冷卻裝置可以解決氣流受阻的局部熱點的散熱問題。
風(fēng)扇
它是拋開無源散熱器和熱管,走向強制風(fēng)冷的有源散熱裝置的第一步,但風(fēng)扇也有讓人頭痛的地方:
1、增加成本,需要空間,增加了系統(tǒng)噪音;
2、容易發(fā)生故障,消耗能量并影響整個系統(tǒng)的效率。
但在很多情況下,尤其是當(dāng)氣流路徑彎曲、垂直或不暢通時,它們通常是獲得足夠氣流的唯一途徑。

定義風(fēng)扇能力的關(guān)鍵參數(shù)是每分鐘空氣的單位長度或單位體積流量。
不過物理尺寸是一個問題:低轉(zhuǎn)速大風(fēng)扇可以產(chǎn)生與高轉(zhuǎn)速小風(fēng)扇相同的氣流,因此存在尺寸與速度的取舍平衡。
建模及綜合仿真
單獨的無源系統(tǒng)尺寸較大,但更可靠高效,而風(fēng)扇可以在不能單獨使用無源冷卻的情況下發(fā)揮作用。
到底選哪種系統(tǒng)進行散熱,往往是一個困難的決定。
這時候需要通過建模和仿真來確定需要多少冷氣以及如何實現(xiàn)冷卻,它對高效熱管理策略至關(guān)重要。

對于微型模型來說,熱源及其熱量流通路徑的特征在于它們的熱阻,而熱阻由其使用的材料、質(zhì)量和尺寸決定。
建模顯示熱量如何從熱源流出,也是評估因自身散熱而導(dǎo)致熱事故組件的第一步。
例如高散熱 IC、MOSFET 和IGBT等器件供應(yīng)商通常會提供熱模型,這些模型能夠提供從熱源到器件表面的熱路徑細節(jié)。

一旦各組件的熱負載已知,下一步就是宏觀層面建模,這既簡單又復(fù)雜:
通過各種熱源的氣流調(diào)整大小以將其溫度保持在允許的限值以下;使用空氣溫度、非強制氣流可用流量、風(fēng)扇氣流量和其他因素進行基本計算大致了解溫度狀況。
接下來就是使用各熱源的模型及位置、PC 板、外殼表面和其他因素,對整個產(chǎn)品及其封裝進行更復(fù)雜的建模。

最后,建模還要解決兩個問題:
1、峰值與平均耗散的問題。例如熱耗散持續(xù)為 1W 的穩(wěn)態(tài)組件與熱耗散 10W 但具有10%間歇占空比的器件具有不同的熱影響。
也就是說平均熱耗散相同,相關(guān)的熱質(zhì)量和熱流量會產(chǎn)生不同的熱分布。大多數(shù) CFD 應(yīng)用程序可以將靜態(tài)與動態(tài)結(jié)合起來進行分析。
2、組件及微型模型表面間物理連接的不完善性,例如 IC 封裝頂部與散熱器之間的物理連接。
如果連接有微小的間距,這條路徑的熱阻就會增加,需要在接觸之面填充導(dǎo)熱墊片增強路徑的導(dǎo)熱性。

熱管理可降低電源中元件及內(nèi)部環(huán)境的溫度,可延長產(chǎn)品使用壽命,提高可靠性。
但熱管理是一個整合的概念,如果分解到細枝末節(jié),是一個龐大的課題。
它涉及尺寸、功率、效率、重量、可靠性以及成本等方面的權(quán)衡,必須對項目的優(yōu)先級和約束條件進行評估。
本文來源:互聯(lián)網(wǎng) 版權(quán)歸原作者所有,轉(zhuǎn)載僅供學(xué)習(xí)交流,如有不適請聯(lián)系我們,謝謝。
標(biāo)簽: 點擊: 評論:
