云道智造“電子散熱模塊”

現階段,各類電子設備普遍采用強制空氣對流的方式來冷卻發熱器件,即通過在芯片上加裝散熱器將芯片散發的熱量傳遞到散熱片上,并加裝風機等設備增強空氣循環,將散熱器上的熱量帶走。
對于典型芯片封裝而言,主要的封裝熱阻包括 Die 結到環境(Junction-to-Ambient)的熱阻 Rja,結到殼(Junction-to-Case)的熱阻 Rjc和結到板(Junction-to-Board)的熱阻 Rjb。其中Rja與器件所處的環境有關,且器件規格書中的規定值一般為生產商基于標準環境測試,而往往實際應用環境和標準測試環境差別較大,Rja很難應用于芯片結溫預計,更多的應用于定性對比不同封裝芯片的散熱能力。因此,在實際應用時,更多的采用結殼熱阻Rjc和結板熱阻Rjb評價器件的散熱能力,由此便產生了雙熱阻模型。
③結點熱量不通過側面傳遞。
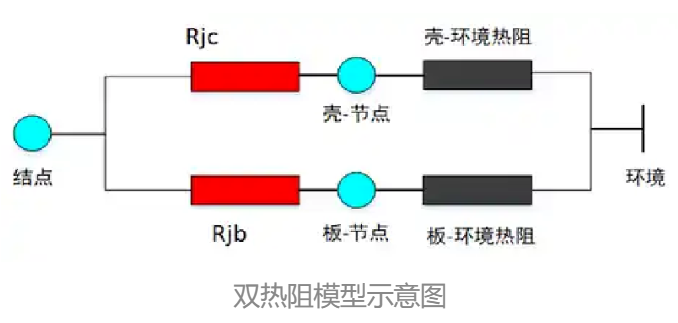
下面就來介紹一下如何使用云道智造“電子散熱模塊”進行“基于雙熱阻模型的芯片封裝中簡單強制對流換熱”仿真分析。
“芯片雙熱阻封裝的簡單強制對流換熱問題”
仿真分析
本算例中建立了包括 1 個機箱、1 個 PCB 板、1 個雙熱阻封裝、1 個軸流風扇、1 個散熱器的簡單強迫對流換熱模型,目的在于雙熱阻封裝模塊的應用,便于熟悉雙熱阻封裝模塊的設置。穩態計算,不考慮輻射。軸流風扇固定流量為 2CFM,垂直出風。
考慮流熱耦合問題;
雙熱阻封裝模塊中,中心節點功耗為 3W;
環境溫度為 30°C。


3.1 網格剖分
本次采用默認Region-based網格劃分方式; 調整全局網格和局部網格設置;

全局網格設置
該案例中主要對重要器件進行局部網格設置,平面方向主要控制最大尺寸,厚度方向則是設置最小網格數,如芯片、板卡等。

局部網格設置
選擇【網格剖分】菜單下的【笛卡爾網格】,點擊進行網格剖分;
網格剖分完成后,選擇【載入網格】,可在【檢查網格】窗口中查看網格質量。

本次模型利用非結構化六面體網格剖分,長寬比33.3,非正交網格大于70的面個數為零,畸形度大于4的面個數為零,網格質量良好,滿足流熱耦合計算要求,如下圖所示。

3.2 模型與求解設置

電路板與雙熱阻封裝的屬性設置

求解設置
本分析類型為穩態、流熱耦合計算。后處理結果可以通過云圖、流線圖、切片以及表格統計的形式進行直觀展示,同時使用方可以根據這些結果對產品的熱設計進行相關評估,后處理結果如下圖所示:


溫度云圖、流線圖

Z方向切片溫度云圖、流線圖

Y方向切片溫度云圖、流線圖

雙熱阻封裝計算結果統計

電路板計算結果統計
本案例采用導熱+對流的形式進行散熱,芯片的熱量分別通過散熱片和電路板進行導熱,而后風扇把散熱齒片和電路板上的熱量通過對流方式帶走。通過以上溫度云圖、流線圖以及統計表格可以得知,在30℃環境溫度下,主芯片殼溫溫升11.37℃,最終溫度達到41.37℃;結溫溫升為21.6℃,最終溫度達到51.6℃。結溫溫度明顯低于規格書要求的最高結溫不超過85℃的要求,說明本案例的散熱設計方案滿足散熱要求,能夠保障芯片穩定可靠的工作。
說明:加入熱設計網企業會員,享有新產品技術推廣,熱設計網活動折扣優惠等權益。
更多會員信息,請關注公眾號:熱設計


