本文來源:Bioengineer
隨著AI大模型、高性能計算(HPC)對算力的需求呈指數級增長,半導體行業早已告別單純依賴晶體管縮放的“摩爾定律”老路。3D堆疊IC技術憑借垂直集成、高密度互連的優勢,成為突破性能天花板的核心方向,但隨之而來的“散熱難題”,正成為制約其商業化落地的最大攔路虎。
為什么3D堆疊IC,偏偏怕“熱”? 3D堆疊IC就像把多片芯片“疊羅漢”,通過垂直方向的互連實現數據高速傳輸,大幅提升芯片性能和集成度。但這種緊湊結構,直接放大了熱管理的難度: 三大核心方向,破解3D堆疊IC散熱困局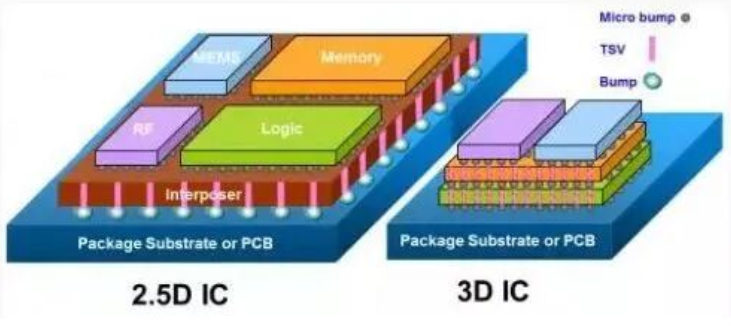
行業正從材料、界面、表征三大維度發力,打造適配3D堆疊架構的先進熱管理方案:
1.新型熱管理材料:既要“導熱快”,也要“好集成”
理想的熱管理材料必須兼顧兩大核心需求:一方面要具備超高導熱性,能快速疏導熱量;另一方面要適配半導體制造工藝,滿足兼容性、可擴展性和經濟性。目前研究聚焦于納米復合材料、高導熱界面材料等,既要突破傳統材料的導熱極限,又要避免影響芯片的電氣性能和可靠性。
2.界面工程優化:打通熱傳輸“最后一公里”
芯片層間、芯片與封裝之間的界面,是熱傳輸的主要阻力來源。通過界面改性、新型粘結材料研發、微結構優化等方式,可減少界面熱阻,讓熱量在不同層級間順暢傳遞,這也是提升3D堆疊IC散熱效率的關鍵抓手。
3.先進熱表征技術:讓“熱”看得見、可量化
要優化熱管理方案,首先得精準掌握熱量分布和傳輸規律。當前行業亟需無損在線計量技術,能在芯片制造和運行過程中,實時評估導熱性能、界面質量和熱點分布,為材料選擇、結構設計提供數據支撐,避免“盲目優化”。
行業“新信號”:液冷從“可選”變“剛需” 解決3D堆疊IC的熱管理難題,并非單一技術能實現,還需要構建完善的支撐體系:

標簽: 芯片元器件 點擊: 評論:
